TrendForce集邦咨询指出,自台积电于2016年开发命名为整合扇出型封裝(InFO)的扇出型晶圆級封裝(FOWLP)技术,并应用于iPhone7 手机所使用的A10处理器后,专业封测代工厂(OSAT)业者竞相发展FOWLP及扇出型面板级封裝(Fan-out Panel Level Package, FOPLP)技术,以提供单位成本更低的封装解决方案。
自第二季起,超威半导体(AMD)等芯片业者积极接洽台积电及OSAT业者以FOPLP技术进行芯片封装,带动业界对FOPLP技术的关注。根据全球市场研究机构TrendForce集邦咨询调查,在FOPLP封装技术导入上,三种主要模式包括「OSAT业者将消费性IC封装方式自传统封装转换至FOPLP」;「专业晶圆代工厂(foundry)、OSAT业者封装AI GPU,将2.5D封装模式自晶圆级(wafer level)转换至面板级(panel level)」;「面板业者封装消费性IC」等三大方向。
从OSAT业者封装消费性IC,自传统封装转换至FOPLP发展的合作案例来看,以AMD与PTI (力成)、ASE (日月光)洽谈PC CPU产品,高通公司(Qualcomm)与ASE洽谈电源管理芯片 (PMIC)产品为主。以目前发展来看,由于FOPLP线宽及线距尚无法达到FOWLP的水平,FOPLP的应用暂时止步于PMIC等成熟制程、成本较敏感的产品,待技术成熟后才会导入到主流消费性IC产品。
若是观察foundry、OSAT业者封装AI GPU,将2.5D封装模式自wafer level转换至panel level合作模式,则是以AMD及英伟达与台积电、SPIL (矽品科技)洽谈AI GPU产品,在既有的2.5D模式下自wafer level转换至panel level,并放大芯片封装尺寸最受到瞩目,只是由于技术的挑战,foundry、OSAT业者对此转换尚处评估阶段。
以面板业者封装消费性IC为发展方向的则以恩智浦半导体(NXP)及意法半导体(STMicroelectronics)与Innolux (群创光电)洽谈PMIC产品为代表。
从FOPLP技术对封测产业发展的影响面来看,第一,OSAT业者可提供低成本的封装解决方案,提升在既有消费性IC的市占,甚至跨入多芯片封装、异质整合的业务;第二,面板业者跨入半导体封装业务;第三,foundry及OSAT业者可压低2.5D封装模式的成本结构,甚至借此进一步将2.5D封装服务自既有的AI GPU市场推广至消费性IC市场;第四,GPU业者可扩大AI GPU的封装尺寸。
TrendForce集邦咨询认为,FOPLP技术的优势及劣势、发展机会及挑战并存。主要优势为低单位成本及大封装尺寸,只是技术及设备体系尚待发展,技术商业化的进程存在高度不确定性,预估目前FOPLP封装技术发展在消费性IC及AI GPU应用的量产时间点,可能分别落于2024年下半年至2026年,以及2027-2028年。
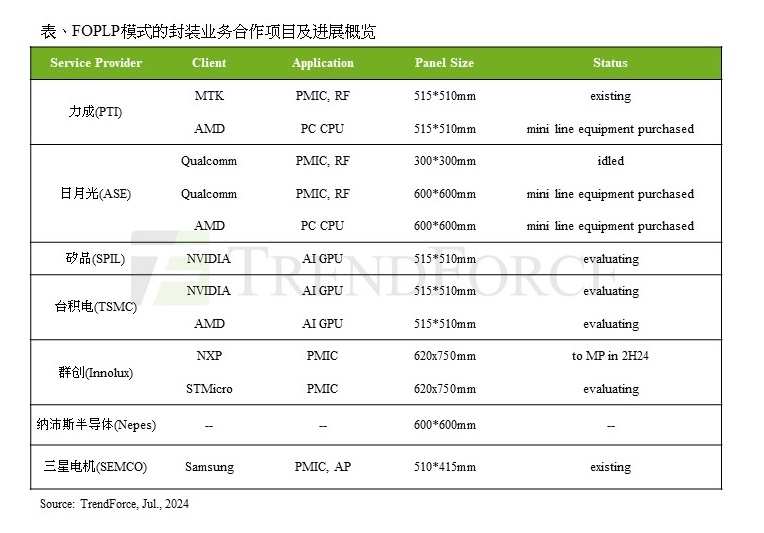
若有兴趣进一步了解并购买TrendForce集邦咨询旗下半导体研究处相关报告与产业数据,请至https://www.trendforce.cn/research/dram查阅,或洽询SR_MI@trendforce.cn。
相关文章
相关报告

